Atomic Force Microscopy (AFM)
AFM measures surface topography of materials with sub-nm vertical resolution. The technique delivers fast data, with simple scans requiring only a few minutes to complete.
The key benefit of using AFM is it is the highest resolution technique for measuring surface roughness with Angstrom z-resolution and nanometer lateral resolution. The technique is non-destructive if operated in non-contact mode
Get Expert Analysis of Your Material
What is Atomic Force Microscopy?
Atomic Force Microscopy (AFM) is a very high-resolution scanning technique in which an ultra-sharp tip is raster-scanned over the sample surface to resolve atomic height variations.
The tip is sensitive to forces such as Van der Waal’s, electrostatic, and magnetic, which depend on the properties of the tip and sample, and tip-sample distance.
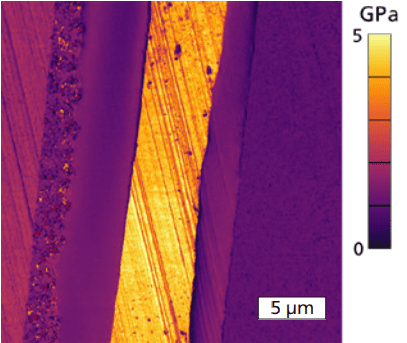
Our Process
Sample Preparation
Samples are cleaned, flattened, and securely mounted. Proper prep ensures stable imaging, especially for delicate materials.
Tip and Cantilever Setup
A suitable AFM tip and cantilever are chosen based on the imaging mode and material. The tip is aligned and installed in the system.
Scanning
The AFM tip scans the surface in raster patterns. Tip-sample interactions are tracked via laser deflection to create high-resolution images.
Analysis and Reporting
Images are processed to extract key metrics like roughness, feature size, and phase contrast. Results are compiled into a detailed report.
AFM Instrument Used
Bruker Nano Dimension (with Icon and FastScan Heads)
Whether using the Icon scanner with ultra-low noise and high accuracy, or employing the FastScan scanner for high scan rates, the Nano Dimension AFM from Bruker delivers exceptional ease of use and fast, high-resolution imaging and analysis.

Strengths
- Best height resolution among surface topography techniques
- High lateral resolution with specialized cantilever tips
- Rapid measurement: possible to capture images within 10 min
- Alternative force probes (including: electric, magnetic, piezoelectric, etc) accommodate advanced analytical modes
Limitations
- Limited field of view. Maximum scan size is 100 µm x 100 µm
- Roughness must be less than 10 microns
- Size, shape, and cleanliness of the tip may obscure the results
Get Precision Insights with AFM today
Partner with Covalent to unlock nanometer-scale details and elevate your materials analysis - reach out now to start your AFM project
